Nano - Metrologie
In vielen industriellen Anwendungsfeldern wie der Elektronik, der Mikrosystemtechnik oder der Optik werden nanoskalige Standards und Kalibriernormale sowie sinnvolle, auf das internationale Messeinheitensystem rückführbare Parameter für nanostrukturierte Oberflächen und Objekte immer wichtiger.
In den letzten Jahren war daher ein starker Anstieg der Aktivitäten im Bereich der Nanometrologie zu verzeichnen, die sich insbesondere mit der Längenmessung und –kalibrierung nanoskaliger Objekte befasst. Für metrologische Einsatzwecke bietet sich insbesondere die Rasterkraftmikroskopie an, die sich einerseits dazu eignet, einzelne Atome an Festkörperoberflächen zu zählen, deren Abstand als Maßstab im Nanometerformat genutzt werden kann. Auf der anderen Seite können mit der Rastersondentechnik auch zweidimensionale Längenkalibrierungen von Oberflächen mit nanoskaliger Genauigkeit vorgenommen werden. Basis hierfür sind hochpräzise Positionierungssysteme, u. a. auf Basis von Piezo – Sensor- / Aktorsystemen und interferometrischen Wegsensoren, mit denen die Bewegung der Probensonde über der Probenoberfläche mit nanoskaliger Ganauigkeit kontrolliert werden kann. Mit dieser Methode lassen sich beispielsweise die Strukturabstände von Kalibriergittern mit einer Präzision im sub – Nanometerbereich vermessen.
Von hoher Bedeutung im Bereich der Nanometrologie ist die Herstellung und Vermessung von Kalibriernormalen, z. B. Linien und Gitter mit definiertem Abstand, mit denen Längenvergleichsmessungen durchgeführt oder auch das Auflösungsvermögen von Mikroskopen bestimmt werden kann. So werden Linienbreitennormale, die über scharfkantige und hochparallele Stegen in definierten Linienabständen verfügen, für die Kalibrierung des Auflösungsvermögens im Bereich der UV – Mikroskopie, der konfokalen Laser – Scanning – Mikroskopie sowie der AFM eingesetzt.
 Die Aufnahmen werden von E. Buhr (PTB), D. Schelle (IAR Jena) und V. Vollrath (Leica Wetzlar) zur Verfügung gestellt.
Die Aufnahmen werden von E. Buhr (PTB), D. Schelle (IAR Jena) und V. Vollrath (Leica Wetzlar) zur Verfügung gestellt.
Die Abbildung zeigt die Leistungsfähigkeit heutiger UV - Mikroskope anhand der Strukturen des nanoskaligen Linienbreiten / Pitch - Normals. Jede Spalte im Bild repräsentiert eine Gitterperiode. Bei Beleuchtungswellenlängen von λ = 365 nm werden Gitter mit einer Periode von 300 nm, bei λ = 248 nm Gitter mit 200 nm Periode klar aufgelöst. Bei Einsatz von Immersionsobjektiven (NA = 1,2) gelingt es, Gitterperioden bis 160 nm (Linienbreite: 80 nm) darzustellen.
Bei den Rastersondertechniken lassen sich durch die Messung von Linienbreitennormalen ebenso die Geometrie und der Radius von Probensonden bestimmen. Mit Hilfe von Kreisgittern lassen sich auf einfache Weise Gerätefehler wie Astigmatismen erkennen und korrigieren. Derartige Kallibriermormale sind u. a. in einem vom
BMBF geförderten Verbundprojekt „Nanoskalige, kalibrierte Breitenmaßverkörperungen für höchstauflösende Inspektionsverfahren“ unter Beteiligung der Firma
Leica aus Wetzlar entwickelt worden. Die messtechnische Charakterisierung erfolgte hierbei mittels optischer, REM- und AFM – Methoden durch die
Physikalisch Technische Bundesanstalt (PTB).
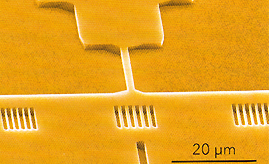 REM - Aufnahme einer Kalibrierstruktur - Gruppen mit unterschiedlichen Linienbreiten von 300 bis 800 nm. (Quelle: Supracon AG)
REM - Aufnahme einer Kalibrierstruktur - Gruppen mit unterschiedlichen Linienbreiten von 300 bis 800 nm. (Quelle: Supracon AG)
Ebenfalls von Interesse im Bereich der Nanometrologie sind zertifizierte Partikelgrößen- und Partikelzählstandards, die beispielsweise von BS – Partikel in Wiesbaden entwickelt und hergestellt werden, mit denen Partikelmessgeräte validiert und kalibriert werden können.
Infolge der immer weiter fortschreitenden Verkleinerung von Strukturgrößen u. a. in der Halbleitertechnik ist die Weiterentwicklung nanoanalytischer Messmethoden im Hinblick auf Präzision und Auflösungsvermögen ein wichtiges Forschungsfeld, mit dem sich insbesondere Metrologieinstitute wie die
PTB in Deutschland oder das
NIST (National Institute of Standards and Technology) in den USA befassen. Darüber hinaus sind Gremien der internationalen Standardisierungsorganisationen ISO und IEC zum Themenfeld Nanotechnologie eingerichtet worden, die sich u. a. explizit mit Fragen der Nomenklatur sowie Prüf- und Messtechniken auch im Bereich der NanoAnalytik befassen.
« zurück
Kontaktieren Sie uns
Supracon AG
An der Lehmgrube 11
07751 Jena
Germany
Tel.: +49-3641-2328100
Fax.: +49-3641-2328109
info(at)supracon.com